
| Суслов А. А., Чижик С. А. Сканирующие зондовые микроскопы (обзор) // Материалы, Технологии, Инструменты – Т.2 (1997), №3, С. 78–89 |  |
УДК 621.385.833
СКАНИРУЮЩИЕ ЗОНДОВЫЕ МИКРОСКОПЫ (обзор)
А. А. СУСЛОВ, С. А. ЧИЖИК
Институт механики металлополимерных систем им. В. А. Белого НАН Беларуси. 246652, г. Гомель, ул. Кирова 32а.
Рассматриваются принципы работы основных типов сканирующих зондовых микроскопов (сканирующего туннельного и атомно-силового). Представлены зондовые технологии, получившие распространение в настоящее время, для реализации которых используются эти устройства, и представляющие собой их вариации или развитие.
ВВЕДЕНИЕ. В 1981 году Герхард Бинниг и Хайнрих Рёрер из лаборатории IBM в Цюрихе представили миру сканирующий туннельный микроскоп (СТМ). С его помощью были получены поразившие всех изображения поверхности кремния в реальном масштабе. Человек впервые смог увидеть атомы и прикоснуться к ним [1–3].
Развивая идеи, заложенные в СТМ, в 1986 году Герхард Бинниг, Калвин Куэйт и Кристофер Гербер создают атомно-силовой микроскоп (АСМ), благодаря которому были преодолены присущие СТМ ограничения [4, 5]. В свою очередь АСМ стал родоначальником широкого семейства сканирующих зондовых устройств и использующих их технологий, которое продолжает увеличиваться и по сей день. В том же 1986 г. Г. Бинниг и Х. Рёрер были удостоены Нобелевской премии в области физики за открытие принципа туннельной, атомно-силовой и световой сканирующей микроскопии [3].
Сканирующие зондовые микроскопы (СЗМ) – таково общее название такого типа устройств – используются сегодня в широком диапазоне дисциплин, включающем как фундаментальную науку о поверхности, так и традиционный анализ шероховатости поверхности. Не менее эффектно применение СЗМ-технологий для построения трехмерных изображений – от атомов до микронных образований на поверхности биологических объектов.
Сканирующий зондовый микроскоп — это инструмент со множеством возможностей. С его помощью можно строить реальные трехмерные изображения с широким динамическим диапазоном, охватывающим традиционные “сферы деятельности” оптических и электронных микроскопов. Это также и профилометр с беспрецедентным разрешением. Сканирующий зондовый микроскоп может измерять такие физические свойства, как, например, проводимость поверхности, распределение статических зарядов, магнитных полей и модуля упругости, свойства смазочных пленок и др. Современные приложения СЗМ весьма разнообразны [6–12].
Изображения, получаемые с помощью СЗМ, относятся к разряду создаваемых микроскопическими методами образам, которые достаточно легко интерпретировать. В случае электронного или оптического микроскопа принцип получения изображения базируется на сложных электромагнитных дифракционных эффектах. Поэтому иногда могут возникнуть затруднения при определении, является ли некоторый элемент микрорельефа поверхности выступом или впадиной. Напротив, СЗМ регистрирует истинно трехмерные параметры. На СЗМ-изображении выступ однозначно предстает выступом, а впадина ясно видна как впадина. На получаемых при помощи оптических или электронных микроскопов изображениях, например, плоского образца, состоящего из чередующихся отражающих и поглощающих участков, могут возникать искусственные изменения контрастности. Атомно-силовой микроскоп, в свою очередь, практически безразличен к изменениям оптических или электронных свойств и дает информацию об истинной топографии поверхности.
В настоящее время в мире в широком ассортименте выпускаются СЗМ и принадлежности
к ним. Среди наиболее известных фирм можно назвать Digital Instruments, Park
Scientific Instruments, Omicron, Topometrix, Burleigh и др. Цены на СЗМ-устройства
промышленного производства колеблются в широких пределах — от 40 тыс. долл.
за простейший АСМ до 100–200 тыс. долл. и выше в зависимости от комплектации
и спектра решаемых задач. Изготавливаются СЗМ также в России (фирмы Nanotechnology
MDT, HTE) и Республике Беларусь (ИММС НАНБ ![]() ).
).
Терминология, сложившаяся в сканирующей зондовой микроскопии, несет на себе отпечаток своего англоязычного происхождения. Для большинства терминов несложно найти русский эквивалент, однако достаточно часто можно слышать и читать, к примеру, не “острие”, а “тип”, не “консоль”, а “кантилевер”, появившиеся от непосредственного прочтения английских “tip” и “cantilever”. Некоторую неопределенность вносят в терминологию появляющиеся в последнее время новые методики. Так, фирма Digital Instruments, впервые реализовавшая в своих устройствах “режим обстукивания”, зарегистрировала само название этого режима как торговую марку – Tapping Mode®. В итоге сходные режимы в СЗМ других фирм, остающиеся по сути тем же процессом, называются иначе.
Все СЗМ содержат компоненты, схематично представленные на рис. 1 [7]. В конструкции каждого сканирующего зондового микроскопа есть свои отличия. В комплекте прибора могут также присутствовать дополнительные устройства, позволяющие модифицировать базовый блок для решения специальных задач. Однако общая структура СЗМ остается более или менее одинаковой. В состав СЗМ-комплекса обычно входит компьютер, который управляет работой электромеханической части микроскопа, принимает и записывает регистрируемые зондом данные, производит на их основе построение СЗМ-изображения и, кроме того, позволяет обрабатывать полученное изображение, без чего подчас бывает трудно или вообще невозможно проанализировать наблюдаемую картину.

Рис 1. Общая схема
сканирующего зондового микроскопа
АСМ и СТМ являются на сегодня наиболее распространенными в практике СЗМ-технологиями. Тем не менее, большинство промышленно выпускаемых устройств обычно разработаны таким образом, что для добавления к прибору новых функций и возможностей достаточно переоснастить его основной блок, заменив отдельные небольшие части. Иногда единственным необходимым изменением является переключение из одного режима в другой непосредственно в обслуживающей компьютерной программе.
СКАНИРУЮЩИЙ ТУННЕЛЬНЫЙ МИКРОСКОП И СВЯЗАННЫЕ С НИМ ТЕХНОЛОГИИ. Сканирующий туннельный микроскоп (СТМ) исторически является предшественником всех сканирующих зондовых микроскопов. СТМ был первым устройством, давшим реальные изображения поверхностей с атомным разрешением [1, 3, 7, 13].
В качестве зонда в СТМ используется острая проводящая игла. Между острием иглы и образцом прикладывается рабочее напряжение, и при подводе острия к образцу примерно до 0,5–1,0 нм электроны с образца начинают “туннелировать” через зазор к острию, или наоборот, в зависимости от полярности рабочего напряжения (рис. 2) [1, 3, 7, 13]. На основании данных о токе туннелирования в СТМ проводится визуализация топографии. Чтобы происходило туннелирование, как образец, так и острие должны быть проводниками или полупроводниками. Изображений непроводящих материалов СТМ дать не может.

Рис. 2. Схема
работы сканирующего туннельного микроскопа
Останавливаясь на физических принципах, положенных в основу работы СТМ, отметим, что процесс туннелирования электронов происходит при перекрытии волновых функций атомов острия сканирующей иглы и поверхности. Туннельный ток между двумя металлическими телами описывается уравнением I = 10exp[–C(jz)1/2]. При типичной высоте потенциального барьера j = 4 эВ туннельный ток снижается на порядок, если зазор z уменьшается на 0,1 нм. Эти свойства и являются причиной того, что острие туннельного микроскопа обычно должно находится так близко к образцу – на расстоянии 0,5–1 нм. Экспоненциальная зависимость туннельного тока от расстояния придает СТМ очень высокую чувствительность: считается, что с помощью туннелирования можно измерять объекты порядка 0,001 нм.
Основное приложение СТМ – это измерения топографии. Именно благодаря своей чрезвычайно высокой чувствительности СТМ способен формировать изображения поверхностей с субангстремной точностью по вертикали и атомным латеральным (т.е. в горизонтальном направлении) разрешением.
Существуют два варианта конструкции СТМ в зависимости от режима сканирования образцов (рис. 3). В режиме постоянной высоты острие иглы перемещается в горизонтальной плоскости над образцом, а ток туннелирования изменяется (рис. 3а). Исходя из данных о величинах тока туннелирования, промеренных в каждой точке сканирования поверхности образца, строится образ топографии [7].

Рис. 3. Схема
работы СТМ: а – в режиме постоянной высоты; б – в режиме
постоянного тока
В режиме постоянного тока СТМ задействуется система обратной связи для поддержания постоянного тока туннелирования путем подстройки высоты сканирующего устройства над поверхностью в каждой точке (рис. 3б). Например, когда система детектирует увеличение туннельного тока, то она подстраивает напряжение, прикладываемое к пьезоэлектрическому сканирующему устройству, так, чтобы отвести острие дальше от образца. В режиме постоянного тока визуализация топографии осуществляется на основании данных о величине вертикальных перемещений сканирующего устройства. Если система поддерживает ток туннелирования постоянным в пределах нескольких процентов, то расстояние между острием и образцом будет постоянным с погрешностью в несколько сотых ангстрема [3, 7, 13].
У каждого режима есть преимущества и недостатки. Режим постоянной высоты более быстрый, так как системе не приходится передвигать сканирующее устройство вверх и вниз, но при этом можно получить полезную информацию только с относительно гладких поверхностей. В режиме постоянного тока можно с высокой точностью измерять нерегулярные поверхности, но измерения занимают больше времени.
Сканирующая туннельная спектроскопия (СТС) является наряду с измерениями топографии другой важной областью приложения СТМ. В первом приближении образ, составленный из значений тока туннелирования, отражает топографию поверхности образца. Если же говорить более точно, туннельный ток соответствует электронной плотности состояний поверхности. В действительности СТМ регистрирует количество заполненных или незаполненных электронных состояний вблизи поверхности Ферми в диапазоне значений энергии, определяемом прикладываемым рабочим напряжением. Можно сказать, что СТМ измеряет скорее не физическую топографию, а поверхность постоянной вероятности туннелирования [2, 7, 14].
Чувствительность СТМ к местной электронной структуре может вызвать затруднения, если необходимо картографировать топографию (т.е. получить изображение топографии). Например, если какой-то участок образца окислен, то, когда острие сканирующей иглы попадет на него, туннельный ток резко уменьшится. СТМ, работающий в режиме постоянного тока, даст команду острию приблизиться к поверхности, чтобы поддержать установленную величину тока туннелирования. В результате острие может углубиться в поверхность. В то же время, чувствительность СТМ к электронной структуре может быть огромным преимуществом. Более традиционные спектроскопические методы, такие как рентгеновская фотоэлектронная спектроскопия, ультрафиолетовая фотоэлектронная спектроскопия или инверсная фотоэмиссионная спектроскопия, детектируют и усредняют данные, исходящие с относительно большой площади размерами от нескольких микрон до нескольких миллиметров в поперечнике. СТМ, наоборот, может получать спектры с площадей, сравнимых по размерам с отдельными атомами.
Электронная структура атома зависит от его разновидности (является ли он, к примеру, атомом кремния или атомом углерода), а также от его местного химического окружения (сколько вокруг него атомов, какого они типа и как симметрично распределены). Исследование зависимости сигнала СТМ от местной электронной структуры поверхности известно как сканирующая туннельная спектроскопия.
СТС охватывает ряд методов: получение “топографических” (в режиме постоянного тока) изображений с использованием различных рабочих напряжений и сравнение их; получение “токовых изображений” (в режиме постоянной высоты) при различных зазорах; варьирование рабочего напряжения при позиционировании острия над интересующим элементом топографии с одновременной регистрацией тока туннелирования.
В последнем случае получают вольт-амперные характеристики электронной структуры в данной точке. Можно настроить СТМ для снятия вольт- амперных кривых в каждой точке сканирования, создавая, таким образом, трехмерную карту электронной структуры. Используя синхронизированный усилитель, можно непосредственно получать кривые зависимостей dI/dU (проводимость) или dI/dz (рабочая функция – изменение тока при изменении зазора) от напряжения U. Все это методы зондирования местной электронной структуры поверхности с применением СТМ.
АТОМНО-СИЛОВОЙ МИКРОСКОП. АСМ появились как развитие СТМ-технологии, однако заложенные в них совершенно иные принципы позволяют исследовать поверхности любых материалов – проводящих, полупроводников, а также изоляторов, т.е. непроводящих электрический ток [2–5, 7, 14–16]. АСМ зондируют поверхность образца острой иглой длиной 1–2 мкм и диаметром обычно не более 10 нм. Игла устанавливается на свободном конце измерительной консоли.
Основной принцип работы АСМ заключается в воздействии сил со стороны поверхности образца на острие сканирующей иглы. Сила, которая чаще всего ассоциируется с АСМ, – это межатомная сила, называемая также Ван-дер- Ваальсовой.
На рис. 4 схематически представлена кривая зависимости межатомной силы от расстояния между острием иглы и образцом. Правая часть кривой характеризует ситуацию, когда атомы острия и поверхности разделены большим расстоянием. По мере постепенного сближения они будут сначала слабо, а затем все сильнее притягиваться друг к другу. Сила притяжения будет возрастать до тех пор, пока атомы не сблизятся настолько, что их электронные облака начнут отталкиваться электростатически. При дальнейшем уменьшении межатомного расстояния электростатическое отталкивание экспоненциально ослабляет силу притяжения. Эти силы уравновешиваются при расстоянии между атомами порядка двух ангстрем, что приблизительно составляет длину химической связи. Когда суммарная межатомная сила становится положительной (отталкивающей), то это означает, что атомы вступили в контакт.
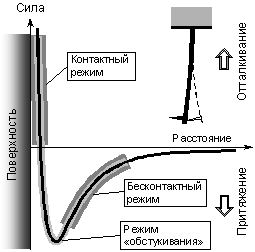
Рис. 4. Зависимость силы межатомного
взаимодействия от расстояния между острием и образцом
В отношении контакта между острием сканирующей иглы и поверхностью исследуемого образца работа атомно-силового микроскопа обычно проходит в одном из режимов, соответствующим обозначенным на рис. 4 участкам кривой межатомного взаимодействия. Это контактный и бесконтактный режимы, сочетание которых дает т.н. режим “обстукивания” [7, 17–19].
При контактном режиме, известном иначе как режим отталкивания, острие сканирующей иглы АСМ приходит в мягкий “физический контакт” с образцом. Измерительная консоль, на свободном конце которой расположена игла, обычно характеризуется низкой константой упругости, величина которой должна быть меньше, чем эффективная константа упругости, удерживающая атомы образца вместе.
Наклон кривой на графике межатомных сил в области отталкивания, или контакта, очень крутой (рис. 4). Вследствие этого отталкивающая сила уравновешивает практически любую силу, которая пытается сблизить атомы друг с другом. Для АСМ это означает, что если измерительная консоль прижимает острие иглы к поверхности, то консоль скорее изогнется, чем ей удастся приблизить острие к атомам образца. Даже если изготовить очень жесткую консоль, чтобы приложить огромную силу к образцу, межатомное расстояние между острием и атомами образца уменьшится ненамного. Вероятнее всего деформируется поверхность образца.
Для контактного АСМ отталкивающая межатомная сила должна быть уравновешена другими усилиями. Это происходит благодаря наличию двух сил – капиллярной и консольной.
Капиллярная сила – это воздействие на острие сканирующей иглы со стороны тонкого слоя влаги, обычно присутствующего на поверхностях, находящихся в обычной среде. Капиллярная сила возникает, когда адсорбированная на поверхности влага приподнимается вокруг острия (рис. 5). Оказываемое на острие сильное притягивающее воздействие (около 10–8 Н) удерживает его в контакте с поверхностью. Величина капиллярной силы зависит от расстояния между острием и образцом.

Рис. 5. Схема
возникновения капиллярной силы
Ввиду того, что острие находится в контакте с образцом, капиллярная сила должна быть постоянной, поскольку расстояние между острием и образцом фактически не изменяется. Другое условие, позволяющее считать капиллярную силу постоянной, это предположение о достаточной однородности слоя влаги.
Воздействие со стороны самой измерительной консоли подобно усилию в сжатой пружине. Величина и знак (отталкивающая или притягивающая) “консольной” силы зависит от отклонения консоли и ее константы упругости. Сила, прилагаемая измерительной консолью контактного АСМ, в отличие от капиллярной является переменной.
Общее усилие, прикладываемое со стороны острия сканирующей иглы к образцу, это сумма капиллярной и консольной сил. Величина суммарной силы варьируется от 10–8 Н (когда измерительная консоль отводится от образца почти с таким же усилием, как вода притягивает острие к его поверхности) до более типичного рабочего диапазона в пределах 10–7...10–6 Н.
В бесконтактном режиме, также известном как режим притяжения, АСМ отслеживает притягивающие Ван-дер-Ваальсовы силы между острием сканирующей иглы и образцом. Зазор между острием и образцом обычно составляет 5–10 нм. На таком расстоянии электронные орбитали атомов острия сканирующей иглы начинают синхронизироваться с электронными орбиталями атомов образца. В результате возникает слабое притяжение, потому что в любой момент времени атомы острия и образца поляризованы в одном и том же направлении. В свободном пространстве эти атомы будут сближаться до тех пор, пока сильное электростатическое отталкивание, описанное выше, не станет преобладающим. Чаще всего бесконтактные АСМ конструируются для работы в динамическом режиме.
Из рис. 4 видно, что в области бесконтактной работы АСМ наклон кривой Ван-дер-Ваальсовых сил более пологий, чем в контактной. Такой пологий наклон означает меньшие отклонения измерительной консоли при реакции на изменения величины зазора между острием и образцом. Кроме того, здесь необходимо использовать более жесткую консоль, так как в противном случае острие сканирующей иглы залипнет на поверхности образца как только приблизится к ней на достаточно малое расстояние, когда начинают работать силы притяжения. Однако следует учитывать, что жесткая консоль в ответ на малые силы отклоняется меньше, чем мягкая, и поэтому для бесконтактного АСМ должна быть использована более чувствительная схема детектирования.
В бесконтактном режиме работы АСМ суммарная сила между острием и образцом небольшая – обычно ~10–12 Н. Эта малая сила является преимуществом при исследовании мягких и упругих образцов. Еще одно преимущество заключается в том, что такие образцы, как, например, кремниевые подложки не загрязняются при контакте с острием.
При исследовании жестких образцов изображения, полученные в контактном и бесконтактном режимах, могут выглядеть одинаково. Однако если на поверхности жесткого образца лежат, к примеру, несколько монослоев конденсированной влаги, то эти изображения могут значительно различаться. АСМ, работающий в контакте, будет проникать через слой жидкости, отображая нижележащую поверхность, тогда как бесконтактный АСМ будет давать изображение поверхности слоя влаги (рис. 6).
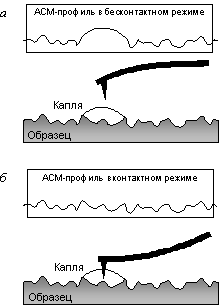
Рис. 6. АСМ-профили при наличии на
поверхности влаги: а – в бесконтактном; б – контактном режиме
В отношении возбуждения вынужденных колебаний измерительной консоли АСМ различают два режима – статический и динамический. Если в измерительной консоли АСМ модулируют колебания, то такой режим называют динамическим, в противном случае – статическим.
В статическом режиме силы взаимодействия между острием иглы и поверхностью образца вызывают отклонение измерительной консоли, изгибая ее до достижения статического равновесия. В процессе сканирования образца (при движении острия над неподвижным образцом или образца под неподвижным острием) АСМ детектирует отклонения консоли, формируя набор данных о топографии одним из двух способов. В первом, называемом режимом постоянной высоты (его другое название – режим переменного отклонения), данные об изменениях положения консоли в пространстве могут быть непосредственно использованы для формирования образа топографии. Под постоянной высотой здесь подразумевается неизменность расстояния между зондирующим узлом и образцом. Режим постоянной высоты часто используется для получения изображений атомно плоских поверхностей в атомном масштабе, где отклонения консоли и, следовательно, изменения прикладываемой силы всегда будут малыми. Режим постоянной высоты также важен для визуализации в реальном масштабе времени изменяющихся поверхностей, когда нельзя пренебречь высокой скоростью сканирования. Аналогичный метод построения изображений с таким же названием существует и у СТМ.
В другом методе, который называют режимом постоянной силы, отклонение измерительной консоли используется в качестве входного параметра для системы обратной связи, которая поддерживает величину этого отклонения постоянной. В данном случае сканирующее устройство передвигается вверх и вниз по оси Z в соответствии с текущими условиями микрорельефа поверхности образца, и на основании данных об этих перемещениях формируется изображение топографии. Режим постоянной силы обычно наиболее предпочтителен в большинстве приложений: хотя скорость сканирования здесь ограничена скоростью реакции системы обратной связи, но общее воздействие, оказываемое на образец острием сканирующей иглы, хорошо контролируется. Действительно, при поддержании постоянного отклонения консоли суммарная сила, прикладываемая к образцу, остается постоянной. Изображения, полученные в режиме постоянной силы, обычно достаточно легко интерпретировать как образы топографии. Если проводить аналогию с СТМ, то подобным здесь будет режим постоянного тока.
В динамическом режиме система АСМ модулирует механические колебания измерительной консоли на частоте, близкой к резонансной (типичные значения находятся в пределах от 30 до 300 кГц), с амплитудой в несколько нанометров. Величина самой резонансной частоты зависит от прикладываемой внешней силы, и поэтому в процессе приближения острия сканирующей иглы к поверхности образца она изменяется, поскольку при этом изменяется и величина Ван-дер-Ваальсовой силы (рис. 4). Отталкивающая сила стабилизирует упругую реакцию консоли и увеличивает резонансную частоту, тогда как при воздействии притягивающей силы наблюдается обратная картина.
В процессе сканирования образца в динамическом режиме система обратной связи АСМ передвигает сканирующее устройство вверх и вниз, сохраняя либо амплитуду, либо резонансную частоту измерительной консоли постоянной, что позволяет поддерживать постоянным и среднее расстояние между острием и образцом. Как и при работе в статическом режиме постоянной силы, данные о передвижениях сканирующего устройства используются для визуализации топографии. При таком методе измеряется и визуализируется поверхность постоянного градиента сил. В качестве альтернативного метода можно получать образы поверхности переменного градиента сил, для чего необходимо просто отключить систему обратной связи. Подобно статическому режиму эти два метода обеспечивают, соответственно, легкость восприятия АСМ-изображения и высокую скорость сканирования. Чувствительность схемы детектирования в динамическом режиме обеспечивает субангстремное вертикальное разрешение на изображениях.
Для получения изображений поверхности образца можно использовать не только данные о перемещении сканирующего устройства (т.н. “запись по высоте”), но и об изменении в процессе сканирования амплитуды или частоты колебаний консоли. В случае “записи по амплитуде” или “по частоте” появляется возможность визуализировать распределение механических свойств по поверхности образца, что дает не менее ценную информацию, чем данные о его топографии.
В таблице дается сравнение основных режимов работы АСМ в их различных комбинациях.
Таблица. Режимы работы атомно-силового микроскопа
|
Статический |
Динамический |
||
|
Контактный |
+ |
Высокое латеральное разрешение. Возможность определять деформацию в системе острие – поверхность. |
Возможность определять площадь контакта или модуль упругости. Высокое силовое разрешение (~0.001 нН). Незначительный температурный дрейф. |
|
– |
Возможно повреждение поверхности.
Низкое силовое разрешение |
Возможно повреждение поверхности. Модуляция нарушает адгезионное взаимодействие между острием и поверхностью. |
|
|
Бесконтактный |
+ |
Работа без повреждения поверхности. |
Работа без повреждения поверхности. Высокое силовое разрешение. Незначительный температурный дрейф.> |
|
– |
Низкое силовое и пространственное разрешение. Подверженность температурному дрейфу. |
Низкое пространственное разрешение (~10 нм). |
|
Качество результатов, которые можно получить на бесконтактном АСМ, в значительной мере зависит от использования качественной измерительной консоли и сканирующей иглы. Измерительная консоль для бесконтактного режима, как отмечалось, должна быть значительно жестче, чем консоль для контактного АСМ, чтобы в процессе своих осцилляций (колебаний) она случайно не коснулась поверхности. Более того, острая игла для бесконтактного АСМ даже более важна, чем для контактного: при работе в бесконтактном режиме наклон кривой Ван-дер-Ваальсовых сил пологий, поэтому с поверхностью образца будет взаимодействовать большее количество атомов острия.
Режим “обстукивания” по сути является реализацией контактного АСМ в динамическом режиме, образ действия которого подобен бесконтактному. В режиме “обстукивания” измерительная консоль колеблется на своей резонансной частоте с высокой амплитудой порядка 100 нм. При каждом колебании острие касается образца в своей нижней точке (отсюда термин режим “обстукивания”). При работе в режиме “обстукивания” повреждение образца менее вероятно, чем в контактном, поскольку в процессе перехода к каждой последующей точке сканирования устраняются боковые (латеральные) силы (трение или протягивание) между образцом и острием. Однако вертикальные силы в режиме “обстукивания” должны быть значительно выше, чем капиллярная сила (10–8 Н), для того чтобы дать острию сканирующей иглы возможность проникать внутрь и выходить из водного слоя без задержки. Эта вертикальная сила достаточно велика, чтобы деформировать поверхность мягких и упругих материалов. Поэтому изображения, полученные в режиме “обстукивания”, часто представляют собой смесь топографии и упругих свойств поверхности образца [17].
КРИВЫЕ ПОДВОДА/ОТВОДА. Аналогом сканирующей туннельной спектроскопии для АСМ является возможность снимать кривые зависимости силы взаимодействия зонда с поверхностью образца от расстояния между ними — кривые подвода/отвода. Эти кривые важны для измерения вертикальной силы, прикладываемой к поверхности со стороны острия в процессе сканирования. Кроме того, анализируя изменения формы этой кривой, можно оценивать вязкость загрязнений поверхности, толщину слоя смазки, а также местные вариации упругих свойств поверхности [7, 8, 15, 16, 20–25].
Кривая подвода/отвода представляет собой график зависимости отклонения измерительной консоли от удлинения сканирующего устройства. Ван-дер-Ваальсовы силы (рис. 4) представляют только одну составляющую, воздействующую на отклонение консоли: на измерения будут дополнительно влиять тонкий слой влаги, обычно присутствующий при работе АСМ на открытом воздухе, а также смазки и загрязнения.
Кривые подвода/отвода, получаемые в лаборатории, достаточно сложны и специфичны для каждого конкретного образца, однако для них можно выделить общие характерные участки, схематично изображенные на рис. 7.

Рис. 7. Номограмма
кривых подвода/отвода.
Сплошной линией схематически показана кривая, получаемая в вакууме.
Пунктирными линиями отмечены вариации кривой подвода/отвода,
обусловленные упругими свойствами образца и присутствием на поверхности слоя
адсорбированной влаги и смазки (загрязнений)
Участок A–B. В левой части кривой сканирующее устройство полностью отведено, и консоль не изгибается, поскольку острие не касается образца. При подводе зонда к поверхности консоль продолжает оставаться неизогнутой до тех пор, пока острие не приблизится к поверхности образца настолько, чтобы на него начала действовать притягивающая Ван-дер-Ваальсова сила (т. В). На этом участке кривая не содержит никакой полезной информации.
Участок В–С. В точке В консоль внезапно изгибается по направлению к поверхности, и игла касается поверхности (т. С). Этот участок известен как “скачок к контакту”. При работе в воздушной среде кроме притягивающей Ван-дер-Ваальсовой и электростатической сил на острие будет дополнительно воздействовать капиллярная составляющая со стороны адсорбированного слоя влаги, а также загрязнений или смазки. Изменение величины силы на участке В–С кривой может быть пересчитано в смещение острия иглы по закону Гука (F = –kx), что позволяет оценить толщину адсорбированного на поверхности слоя.
Участок С–D. Этот участок характеризует дальнейший подвод зонда к образцу, сопровождающийся прижатием острия иглы к поверхности и почти линейным изгибом измерительной консоли в направлении от поверхности. По конфигурации участка C–D можно судить о модуле упругости системы “зонд–поверхность”. В случае, если измерительная консоль намного мягче поверхности образца, как например, в случае неразрушающего сканирования, наклон кривой большей частью отражает величину константы упругости самой консоли. Однако, когда жесткость консоли намного больше жесткости поверхности, наклон участка C–D позволяет исследовать упругие свойства образца [21, 26]. Участок С–D не обязательно должен быть прямой линией: изменения наклона в пределах этого сегмента кривой указывают на различие в реакции поверхности на различную прикладываемую силу. Это может происходить по причине перехода от упругой к пластической деформации, различия в поверхностных и объемных свойствах, а также изменения в составе образца по глубине.
Участок D–E. Точка D соответствует завершению фазы подвода и началу отвода зонда от поверхности. При отсутствии гистерезиса сканирующего устройства сегмент D–E практически повторяет участок С–D кривой, полученный при подводе. Если оба эти участка прямые и параллельны друг другу, то дополнительной информации (кроме отмеченной выше) они не содержат. В случае их непараллельности различие между ними дает возможность оценить либо пластическую, либо упругую деформацию образца (если скорость восстановления его геометрических размеров меньше скорости отвода зонда).
Участок E–F. Точка Е соответствует нейтральному отклонению консоли. При дальнейшем отводе зонда от поверхности консоль начинает изгибаться в направлении к образцу, поскольку на острие воздействует притягивающая, или адгезионная сила. На конфигурацию участка E–F влияет наличие на поверхности адсорбированных слоев. В случае работы в вакууме на острие иглы воздействуют Ван-дер-Ваальсова и, возможно, электростатическая силы. Если же снятие кривых происходит на воздухе, то к ним обычно добавляется достаточно мощная капиллярная сила со стороны слоя влаги, смазки или загрязнений. Толщина приповерхностного слоя влияет на длину участка E–F, а его наклон, отличающийся от наклона участка, соответствующего реакции жесткого образца, будет указывать на поднятие адсорбированных слоев вслед за отводимым зондом.
Участок F–G. Когда упругая реакция консоли превосходит притягивающую силу со стороны поверхности и находящихся на ней слоев, зонд отрывается от образца. На кривой подвода/отвода этому соответствует точка F, известная под названием точки отрыва. Величина усилия в точке F равна максимальной общей адгезионной силе между зондом и образцом и представляет ключевую информацию при исследованиях адгезии. Если слой влаги дополнительно покрыт слоем смазки или загрязнений, то можно наблюдать не одну точку отрыва (Рис. 7, тт. F1 и F2). Положение точек F1 и F2 зависит от вязкости и толщины этих слоев. Переход между участками E–F и F–G не обязательно представляет собой резкий скачок. Если адсорбционный слой достаточно вязкий, то зонд может отходить от поверхности постепенно, а переход E–F – F–G будет иметь в этом случае скругленные очертания.
ЛАТЕРАЛЬНО-СИЛОВОЙ МИКРОСКОП (ЛСМ) – это контактный АСМ, отображающий латеральные (т.е. боковые) отклонения измерительной консоли (закручивание), которые возникают в ней в плоскости параллельной поверхности образца. с помощью ЛСМ возможна визуализация изменений поверхностного трения, являющихся результатом негомогенности материала поверхности, а также для получения контрастных изображений любых поверхностей [5, 7, 12, 27, 28].
С созданием ЛСМ связано возникновение такой области исследований, как нанотрибология: эта технология предоставляет исключительную возможность исследовать процессы трения и изнашивания на молекулярном уровне при взаимодействии как отдельных выступов микрорельефа, так и отдельных атомов или молекул [9, 27, 28].
Как показано на рис. 8, латеральные отклонения консоли обычно возникают по двум причинам: изменение наклона поверхности и изменение ее фрикционных параметров (коэффициента трения). В первом случае консоль может закручиваться, когда ей попадается постепенный наклон. Во втором случае сканирующая игла, пересекая некоторый участок, может испытать большее трение, вызывая тем самым и большее закручивание измерительной консоли. Чтобы разделить эти два эффекта, ЛСМ должен “уметь” одновременно считывать данные о латеральном и вертикальном отклонении (т.е. визуализировать топографию).
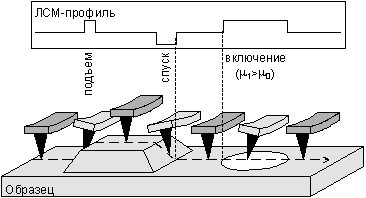
Рис. 8. Элементы ЛСМ-
профиля образца, отражающие прохождение сканирующей иглой участков с измененным
наклоном поверхности и с отличающимся коэффициентом трения m1
МАГНИТНО-СИЛОВОЙ МИКРОСКОП (МСМ) отображает пространственные вариации магнитных сил на поверхности образца. Особенностью конструкции МСМ является то, что острие сканирующей иглы покрывается тонкой ферромагнитной пленкой (рис. 9). МСМ работает в бесконтактном режиме и детектирует изменения в резонансной частоте измерительной консоли, обусловленные изменениями магнитного поля в зазоре между острием сканирующей иглы и образцом. МСМ может визуализировать естественно встречающиеся и свободно записанные доменные структуры в магнитных материалах [7, 11].
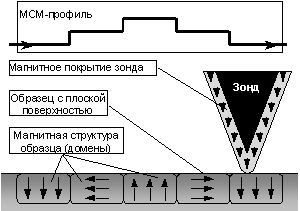
Рис. 9. Схема работы
магнитно-силового микроскопа. МСМ-профиль отображает магнитную структуру
поверхностного слоя образца
Изображения, полученные с помощью МСМ, содержат информацию как о топографии, так и о магнитных свойствах поверхности. Какая информация преобладает на изображении, зависит от величины расстояния между острием и поверхностью, потому что межатомная магнитная сила существует при больших зазорах, чем это наблюдается для Ван-дер-Ваальсовой силы. Если острие находится близко к поверхности (<10 нм), то в режиме работы стандартного бесконтактного АСМ на изображении будет отражена преимущественно топография. При увеличении зазора между острием и образцом (примерно до 30–300 нм) влияние топографии снижается, и становятся видны магнитные эффекты. Анализируя ряд изображений, полученных при различной высоте острия над поверхностью, можно успешно отделить магнитные эффекты от влияния топографии. Подобное поведение характерно также и для электростатических сил.
В ЭЛЕКТРОСТАТИЧЕСКОМ СИЛОВОМ МИКРОСКОПЕ (ЭСМ) напряжение прикладывается между острием и образцом, в то время как измерительная консоль движется над поверхностью, не касаясь ее. Консоль отклоняется, когда попадает на статически заряженные области (рис. 10). Величина этого отклонения пропорциональна плотности заряда и может быть измерена стандартной системой. ЭСМ применяется для исследования распределения поверхностной плотности носителей заряда [7].
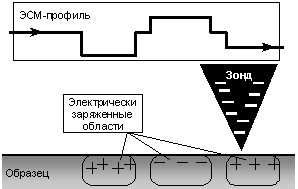
Рис. 10.
Картографирование электростатических полей с помощью ЭСМ
Методы МИКРОСКОПИИ ПОВЕРХНОСТНЫХ СВОЙСТВ используют возможность отслеживания и регистрации амплитуды и частоты колебаний зонда (измерительной консоли) в процессе сканирования. Устройства, реализующие такие методики, представляют собой АСМ, в конструкции которого предусмотрена возможность модуляции вынужденных колебаний в зонде или образце. Эти методы обычно позволяют одновременно с получением изображений топографии также регистрировать изменения механических свойств поверхности образца [7–10, 23].
На рис. 11а представлен вариант, когда АСМ работает в контактном режиме, и в измерительной консоли возбуждаются колебания с постоянной амплитудой А. С помощью системы обратной связи отклонение консоли поддерживается постоянным; частота ее колебаний изменяется в соответствии с жесткостью сканируемого участка поверхности. Таким образом можно, например, выявлять разнородные включения в материале поверхности.
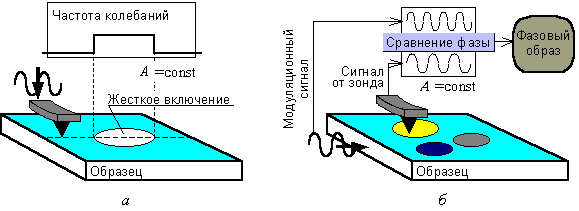
Рис. 11.
Визуализация механических свойств поверхности:
а – при отслеживании частоты колебаний зонда (частота увеличивается на
более жестких участках);
б – при записи разности фаз частоты сигнала, прикладываемого для
возбуждения колебаний, и частоты колебаний зонда
(построение фазового образа)
Аналогично, при поддержании постоянной частоты колебаний консоли и регистрации изменений их амплитуды возможна визуализация распределения вязких характеристик поверхности. При этом на более вязких участках амплитуда будет меньше.
Механические свойства поверхности можно исследовать также путем построения ее фазового образа (рис. 11б). Для этого необходим АСМ, работающий в динамическом режиме. Как и в предыдущих случаях, в измерительной консоли или образце модулируются вынужденные колебания. Система при этом сравнивает реальную частоту колебаний консоли с частотой сигнала, прикладываемого для возбуждения колебаний. Изменения в сдвиге фаз между этими двумя сигналами будет отражать изменения механических свойств поверхности образца.
С помощью СКАНИРУЮЩЕЙ ТЕРМАЛЬНОЙ МИКРОСКОПИИ (СТерМ) можно визуализировать локальные вариации теплофизических параметров поверхностей [7]. Данная методика реализуется за счет использования терморезистивного зонда, работающего в одном из двух режимов — постоянного тока или постоянной температуры.
В первом случае электрическое сопротивление термочувствительного зонда изменяется вместе с изменением температуры в данной точке сканирования. Это регистрируется путем измерения падения напряжения при пропускании через зонд слабого постоянного тока, исключающего, однако, его нагрев. При такой схеме работы картографируются температурные поля на сканируемой поверхности.
В режиме постоянной температуры отслеживается тепловой поток от зонда к образцу при поддержании постоянной температуры зонда, что позволяет визуализировать локальные изменения теплопроводности поверхности образца. Набор данных составляется из значений напряжения, прикладываемого к зонду для его обогрева и изменяющегося в каждой точке сканирования в зависимости от теплопроводности материала образца.
БЛИЗКОПОЛЬНАЯ СКАНИРУЮЩАЯ ОПТИЧЕСКАЯ МИКРОСКОПИЯ (БСОМ) является особой разновидностью сканирующей зондовой технологии, в которой используется видимый свет [7]. Другое название этой методики — сканирующая световая микроскопия. Традиционно разрешение оптических микроскопов ограничено длиной волны света — примерно половиной микрона. БСОМ улучшает разрешение оптического микроскопа на порядок.
Зондом в БСОМ является “световая воронка”, которой сканируют образец. Видимый свет исходит из узкого конца световой воронки диаметром 10–30 нм и попадает на детектор либо после отражения от образца, либо пройдя сквозь него. Интенсивность оптического сигнала регистрируется детектором в каждой точке измерений, а набор данных, считанных со всей сканируемой поверхности, составляет БСОМ-образ. С помощью БСОМ можно формировать изображение поверхности в видимом свете с разрешением около 15 нм при условии, что расстояние между источником света и образцом очень мало – ~ 5 нм.
Световая воронка и система поддержания постоянного расстояния между источником света и образцом – это две достаточно “тонкие” части БСОМ. Обычно световая воронка изготавливается нагреванием оптического волокна, протяжкой его до малого диаметра с проследующим скалыванием с одного конца. После этого на волокно для лучшей светопроводимости наносят слой металла (металлизируют). Другой способ изготовления световой воронки предусматривает высверливание небольшого отверстия в острие пустотелой сканирующей иглы АСМ и направление внутрь ее света. Разработка эффективной световой воронки в настоящее время является областью активных исследований.
БСОМ должен поддерживать расстояние между острием сканирующей иглы и образцом постоянным, чтобы получить простое оптическое изображение поверхности. Для этого могут быть использованы традиционные для АСМ методики поддержания постоянного отклонения измерительной консоли.
Одной из эффектных СЗМ-технологий является НАНОЛИТОГРАФИЯ. Обычно СЗМ применяются для формирования изображения поверхности без ее повреждения. Однако АСМ или СТМ могут быть использованы для направленной модификации поверхности путем приложения либо повышенной нагрузки в случае АСМ, либо повышенных пульсаций тока в случае СТМ. Эта технология известна как нанолитография. Примеры поверхностей, которые были с помощью подобных методик модифицированы атом за атомом, появлялись не только в научной литературе, но также в газетах и популярных журналах [3]. Большинство СТМ могут быть использованы и для нанолитографии, если они содержат устройства для генерации повышенных пульсаций тока. В случае АСМ необходимо, чтобы он имел возможность работать в контактном режиме. Кроме того, необходимым условием является контролируемое перемещения острия зонда по схеме, задаваемой оператором.
В заключение, комментируя возможность элементного распознавания атомов, необходимо отметить, что в настоящее время никакая технология СЗМ не может позволить определить тип атома или молекулы при отсутствии другой информации. Тем не менее, с помощью СЗМ можно проводить ограниченную идентификацию материалов. Выше уже обсуждалось использование для этих целей данных об электронной структуре. Кроме того, сегодня реальностью является картографирование жесткости и вязкости поверхностей с использованием модуляционных силовых методов. С помощью ЛСМ можно также попытаться идентифицировать материалы, основываясь на различиях в их фрикционных свойствах. Например, сила трения острия сканирующей иглы по полимерной матрице и материалу заключенного в ней наполнителя будет различной. Чтобы классифицировать материалы, взяв за критерий упругие свойства, необходимо снимать кривые подвода/отвода на элементах АСМ-изображения. Наконец, притягивающее Ван-дер-Ваальсово взаимодействие, используемое в бесконтактном АСМ, может оказаться чувствительным к типам атомов – ведь пределы чувствительности материалов не изучены пока что достаточно глубоко.
ОБОЗНАЧЕНИЯ
C – постоянная, =10,25 эВ–1/2 нм–1; j – высота потенциального барьера; z – расстояние между электродами; U – напряжение; I – ток туннелирования; m; – коэффициент трения; А – амплитуда.
ЛИТЕРАТУРА
Suslov A. A., Chizhik S. A.
Scanning probe microscopes (a review)
Basic types of the scanning probe microscopes – scanning tunneling and atomic force ones – as well as principles of their operation are considered in the review. Described are some other currently spreaded probe technologies built on the basis of the latter instruments.
© А. А. Суслов, С. А. Чижик, 1997.
This page was prepared by A. Suslov 10.10.98